跟小编一起来看看近期国内外电子材料领域都有哪些最新研究进展把~
1
科研动态
1、IEEE T. Comp. Pack. Man.:退火工艺对Ag纳米层Cu键合质量的影响
大规模生产中,晶圆间铜键合的关键要求之一是防止铜表面氧化。
近日,首尔科技大学的研究人员提出一种策略,利用Ag纳米层同时实现铜键合的表面抗氧化和低温键合。主要评估了退火工艺对铜键合质量的影响。首先使用蒸镀法在Cu表面包裹15 nm厚的Ag层,在180℃的温度下进行30分钟的晶圆与晶圆的铜键合,然后在200℃下退火60分钟。退火过程使铜完全扩散到键合界面,形成均匀的纯铜-铜键合。然而,Ag纳米层没有完全溶解到Cu薄膜中,并形成了薄的Ag带。经过退火处理的试样的平均剪切强度约为6.5 MPa,相对较低。尽管如此,当在铜键合中使用Ag纳米层时,退火工艺已被证明是形成均匀键合界面和纯铜-铜键合的有效方法。该文章以“Effect of the annealingprocess on Cu bonding quality using Ag nanolayer”发表于IEEE T. Comp. Pack. Man.上。
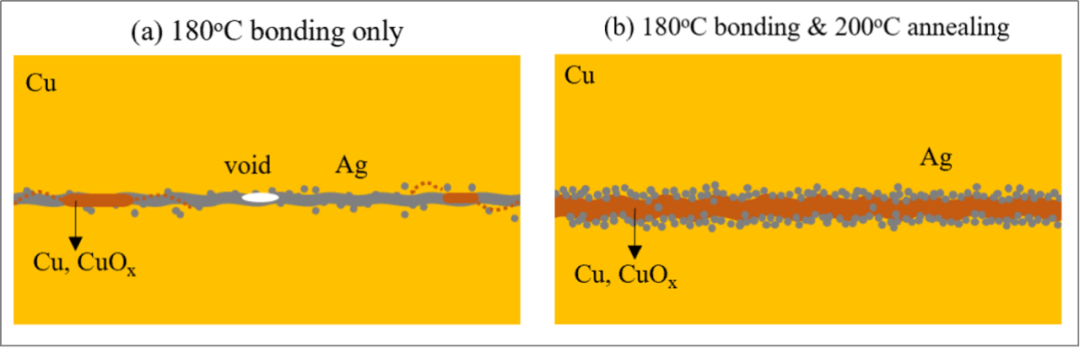
图1. 粘接界面示意图(a)未退火(b)200℃退火
论文链接:DOI:10.1109/TCPMT.2023.3278254
2、 IEEE T. Comp. Pack. Man.:液态金属低电阻互连技术
人们希望互连技术能够提供低接触电阻、更短的电路,并且无需复杂的装载结构即可实现引脚数缩放。球栅阵列(BGA)技术具备一定的优势,但是在尤其是大尺寸的封装上,增加了表面贴装挑战的复杂性。此外,客户看重插座(socket)的可分离连接的灵活性。然而,插座的高接触电阻和所需的加工压力会显著提升装载结构的成本和复杂性。
近日,英特尔公司的研究人员介绍了一种基于液态金属的插座互连技术。该技术可提供类似BGA的性能,同时具有传统插座的优点。实验研究的液态金属是一种低熔点的镓基共晶合金。测得的接触电阻是所有插座技术中最低的,与永久焊点连接接近。文章还介绍了制造液态金属互连的工艺及其电特性。值得注意的是,传统的评估方法难以评价这种新型互连,因此同时还引入了新的评估方法。由于该技术尚处于起步阶段,可靠性风险或潜在故障机制的研究数据还不不充分。该研究为新型互联技术提供了新的思路。该文章以“Liquid Metal Based Low Resistance Interconnect Technology”发表于IEEE T. Comp. Pack. Man.上。
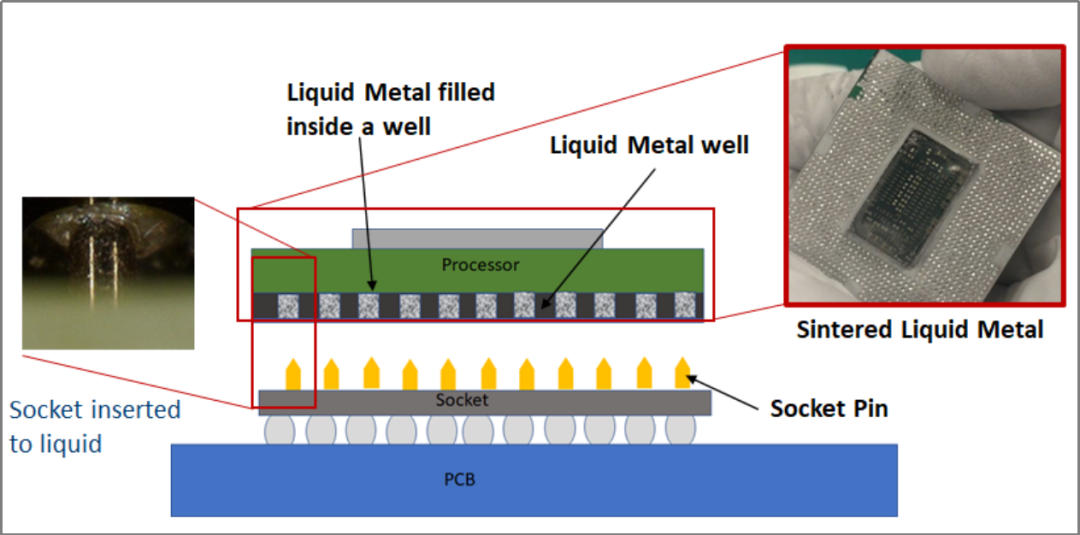
图2. 插入液态金属和插座引脚的台式处理器
论文链接:DOI:10.1109/TCPMT.2023.3274743
3、J. Electron. Packaging:基于表面能的倒装封装底部填充流动过程分析模型的方法开发
倒装封装是一种广泛应用的先进封装技术,底部填充材料的主要作用是减少芯片和基板之间的应力,避免焊点失效。准确的数学模型有助于更好的理解和控制底部填充过程。
近日,华东理工大学等机构的研究人员提出了一种建立倒装封装中底部填充过程分析模型的方法,基于表面能概念和能量守恒原理,预测流动前峰(flow front)和填充时间。该方法不需要对流动路径建模,因此适用于不同的焊点布局情况,包括倒装封装中焊点不同的形状和排列方式。为验证该方法的有效性,实验人员在自行开发的试验台上进行了计算流体力学的模拟实验。实验和仿真结果表明,该方法及其模型对于具有不同焊点结构和布局的倒装芯片封装都是准确的。该工作为芯片底部填充材料的研发提供了参考。该文章以“A Surface Energy Approach to Developing an Analytical Model for the Underfill Flow Process in Flip-Chip Packagin”发表于J. Electron. Packaging上。

图3. 单通道底部填充过程的流体力学仿真
(a)方形排列圆柱形焊点(b)正三角形排列圆柱形焊点
(c)方形排列球形焊点(d)正三角形排列圆柱形焊点
论文链接:https://doi.org/10.1115/1.4052275
4、J. Electron. Packaging:Cu/Cu41Sn11/Cu焊点在高温老化过程中的微观结构演变和力学性能研究
焊点作为连接芯片和载板的桥梁,它不仅提供机械支撑和物理保护,还具有集成电路的信号传输和热冷却功能。这意味着焊点的可靠性在电子产品的性能中起着至关重要的作用。
近日,北京工业大学的研究人员对全Cu41Sn11焊点(Cu/Cu41Sn11/Cu)在420℃等温老化过程中的微观结构和机械性能变化进行了研究。实验结果表明,Cu41Sn11相在高温条件下是不稳定的,在温度老化进行到150 h时,全Cu41Sn11焊点转变为全α(Cu)焊点(Cu/α(Cu)/Cu)。形成的α(Cu)相是Sn原子浓度不均匀的Cu固溶体,其晶体结构和取向与原始Cu盘一致。Cu41Sn11向α(Cu)的转化过程中,在焊点界面的中间部分附近,由于体积收缩效应形成了空隙。与Cu41Sn11焊点相比,α(Cu)焊点的强度有所下降,但应变速率敏指数有所上升。此外,α(Cu)和Cu41Sn11的应变速率敏感指数低于普通Sn焊料。剪切试验中Cu41Sn11晶粒中发生的断裂是脆性的,而α(Cu)晶粒中的断裂是韧性的。该研究为Cu-Sn金属间化合物(IMCs)焊点在第三代宽带隙半导体器件中的潜在应用提供了指导。该文章以“Study on the Microstructure Evolution and Mechanical Properties of Cu/ Cu41Sn11/Cu Solder Joint During High-Temperature Aging”发表于J. Electron. Packaging上。

图4. 420℃不同老化时间下全Cu41Sn11焊点的截面微观结构:
(a)0 h、(b)20 h、(c)100 h、(d)150 h、(e)和(f)A、B点EDS结果
2
行业动态
1、日月光(ASE)扇出型基板桥接(FOCoS-Bridge)封装
越来越多的行业和学科已经涉及到人工智能的使用,高性能计算(HPC)同时也对创新型先进封装提出了需求。
近日,ASE开发了一种扇出型基板桥接(FOCoS-Bridge)封装,该封装技术利用高度集成的扇出结构来克服传统电器互联的局限性,并实现处理器、加速器和内存等模块之间高速、低延迟和高效能的数据通信。在70×78 mm的FOCoS-Bridge封装中,ASE使用一种硅桥技术实现Chiplet集成,该技术利用具有布线层的微小硅片作为芯粒之间的封装内互联。封装结构中包含2个ASIC和8个通过硅桥连接的高带宽储存器件(HBM),也就是在大的封装结构内,并排集成了两个相同的47×31 mm FOCoS-Bridge结构,每个结构分别包含1个ASIC、4个存储器件和4个硅桥。

图5. FOCoS-Bridge封装结构外观示意图
FOCoS-Bridge封装的制造工艺
首先,将待嵌入的带有微凸块的硅桥芯片连接到晶圆载体上,然后在晶圆载体上镀铜柱(图6A)。随后进行第一次塑封加工,将塑封后的产品研磨以露出Cu柱和微凸块,然后在其上形成RDL层,之后再连接ASIC和HBM,进行底部填充和成型(图6B)。移除晶圆载体并形成C4凸块后,将模制晶圆切割成单独的扇出封装(图6C)。最后,使用常规倒装芯片工艺将扇出封装连接到有机基板上(图6D)。
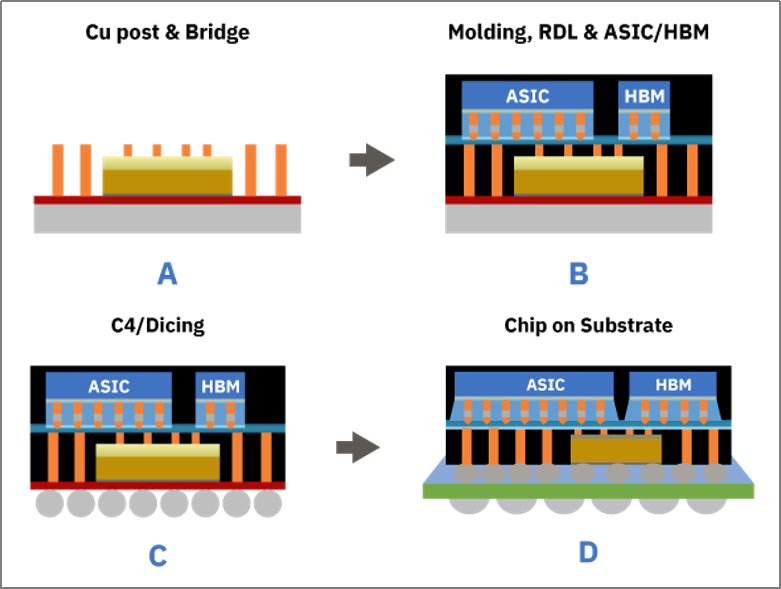
图6. FOCoS-Bridge封装的制造工艺流程示意图
FOCoS-Bridge封装的优势
FOCoS-Bridge被定位为使用硅中介层的2.5D封装的替代品。与2.5D封装一样,硅桥在封装中提供超细间距互连,可以解决系统中的内存带宽瓶颈挑战。与2.5D相比,FOCoS-Bridge的优势在于只在两个芯粒连接在一起的区域使用硅片。
FOCoS-Bridge技术能实现与硅中介层的类似性能,但成本更低,且具有高度可扩展性,能够无缝集成到高性能计算和人工智能应用中使用的复杂Chiplet架构中。它提供高密度芯片到芯片连接、高 I/O 数量和快速信号传输。使用硅桥芯片可实现比传统有机倒装芯片封装高一个数量级的芯片边缘线性密度。
此外,FOCoS-Bridge为在扇出封装中嵌入无源器件和有源芯片奠定了基础,有助于更有效地利用计算资源,加速数据密集型工作负载,并有助于推进AI算法、深度学习、科学模拟和其他计算要求苛刻的任务。
(Source:EDN、ASE)




