1
电子封装材料
1、IEEE T. Comp. Pack. Man.:IMC厚度对微凸点机械性能的影响
由于电子产品向高密度、小尺寸的方向不断发展,互连焊点的尺寸也在不断缩小。在正常使用条件下,微小焊点将同时受到多种载荷的作用,这将导致封装结构中出现许多可靠性问题。
近日,中国电子科技集团公司第三十八研究所等机构的研究人员分析了热压键合过程中金属间化合物(IMC)的生长模式,以及对铜柱微凸点的剪切强度和蠕变性能的影响。首先,通过调整热压键合过程中的键合参数,得到不同IMC厚度的焊点,并分析IMC在热压键合过程中的生长模式。其次,对具有不同IMC厚度的焊点进行剪切实验,并分析IMC对焊点剪切强度和剪切断裂模式的影响。最后,对不同IMC厚度的圆柱形焊点在不同应力条件下进行蠕变实验。实验结果显示,在整个键合过程中,铜原子在温度梯度(JTM)和浓度梯度(JCM)的共同作用下迁移,IMC呈现不对称生长趋势,生长速率随键合保持时间的增加而逐渐减小。在相同的温度条件下,焊点的剪切强度随着保持时间的增加呈现先增加后减小的趋势。此外,随着IMC厚度的增加,焊点的剪切断裂模式从初期的韧性断裂变为韧脆组合断裂,最终演变为脆性断裂。随着应力的不断增加,所有焊点的稳态蠕变应变速率增加,并且断裂位置倾向于从焊点内部靠近焊点和铜柱的交汇处。随着IMC厚度的增加,焊点的稳态蠕变应变速率呈现出先下降后上升的趋势。该项工作为电子封装微凸点可靠性研究提供了参考。该文章以“Effect of IMC thickness on the mechanical properties of micro-bumps”发表于IEEE T. Comp. Pack. Man.上。
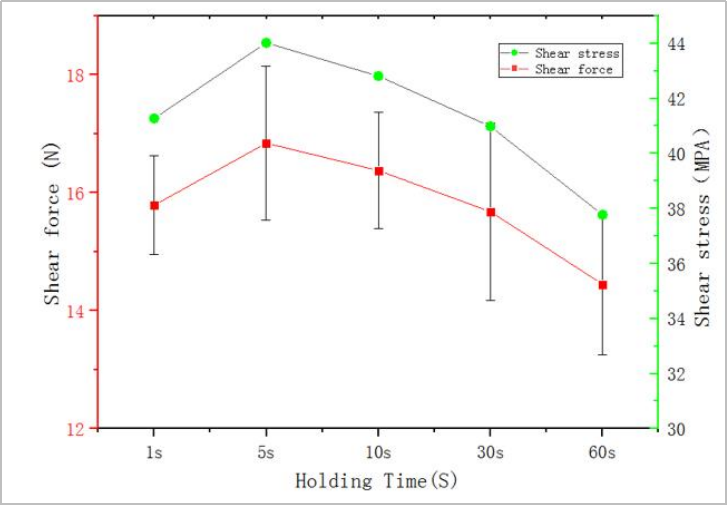
图1. 焊点的剪切强度随键和保持时间的变化趋势
论文链接:
DOI: 10.1109/TCPMT.2023.3250467
2、IEEE T. Comp. Pack. Man.:双层纳米银膏无压烧结嵌入式冷却SiC功率模块的可靠性检验
近年来,研究人员已经发明许多不同的中空基板,应用于嵌入式散热功率模块。通过使用低应力残留的多层纳米银浆组合无压烧结来获得合格的热界面材料(TIM)接合是这些易碎堆叠封装中的一个必要工艺。
近日,中国科学院微电子研究所等机构的研究人员通过进行烧结和功率循环过程,研究了双层纳米银膏整体无压烧结TIM接头的可靠性问题。根据Anand粘弹性本构模型的预测,在TIM接头内的最大残余应力仅为63.18 MPa,远低于封装材料的拉伸强度。从所有的扫描电子显微镜(SEM)、X射线和扫描声学显微镜(SAM)图像研究中,上下层纳米银膏整体无压烧结的TIM接头(50 ± 10 μm厚度)的上下部分仅含有少量的裂纹和分层(孔隙率分别为1.6 ± 0.1%和8.5 ± 0.1%)。测得烧结TIM接头上下部分的键合强度分别达到了38 ± 2 MPa和63.8 ± 2 MPa,高于行业要求(30 MPa)。在经过21,000次功率循环后,烧结TIM接头上下部分的热阻仅增加了10.3%和5.3%,远低于失效标准(20%)。该多层纳米银浆组合无压烧结工艺有望应用于嵌入式散热功率模块堆叠封装。该文章以“Reliability Inspection for Bilayer Nanosilver Paste Ensemble Pressureless Sintered Embedded Cooling SiC Power Module”发表于IEEE T. Comp. Pack. Man.上。
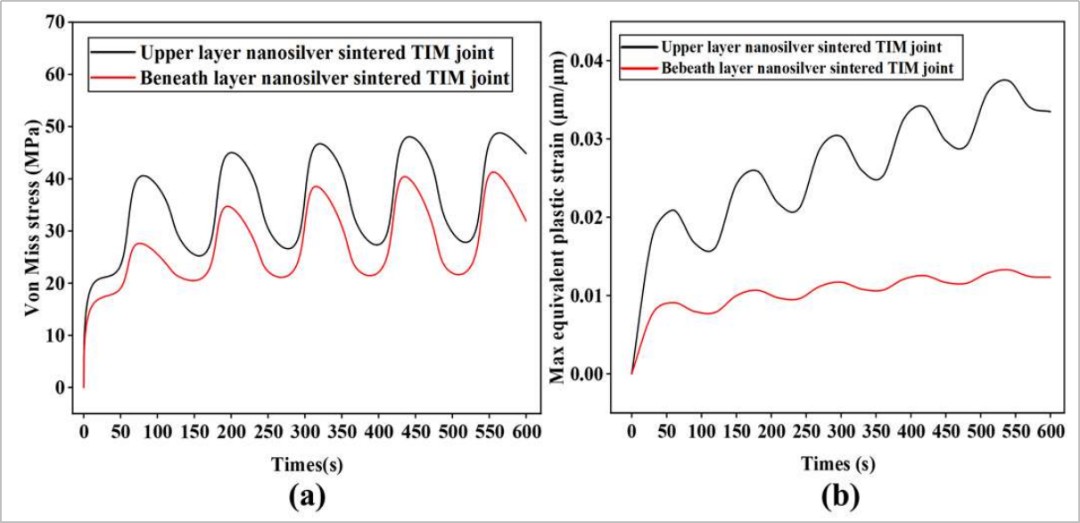
图2.功率循环下纳米银烧结TIM接头上下部分的(a)冯米塞斯应力、(b)塑性应变
论文链接:
DOI: 10.1109/TCPMT.2023.3243737
3、J. Electron. Packaging:利用数值模拟的虚拟样机优化设计以确保电子组件组装和互连中的热机械可靠性
车载领域对电子元件的运行条件比消费电子苛刻很多,除了振动、灰尘和湿度的影响外,更极端的温度负载通常也会阻碍低成本高集成度组件的应用。
近日,弗劳恩霍夫电子纳米系统研究所等机构的研究人员提出了一种方法,使用“虚拟样机(virtual prototyping)”技术来评估电子封装的热机械可靠性。首先通过有限元模拟,对比了虚拟倒装球栅阵列封装(FC-BGA)和参考芯片级封装(CSP),然后使用组合测量-模拟技术,以参考对象为基础,对有限元模拟进行校准。校准是基于通过模拟和光学测量获得的平面变形场(使用基于灰度相关方法的光学传感器进行平面变形和应变场分析)。该研究方法适用于其他具有类似设计的封装类型的失效分析,以在物理制造之前评估其对期望应用的适用性。该项工作为如何经济、高效地评估电子封装设计的热机械可靠性提供了有力参考。该文章以“Design Optimization by Virtual Prototyping Using Numerical Simulation to Ensure Thermomechanical Reliability in the Assembly and Interconnection of Electronic Assemblies”发表于J. Electron. Packaging上。
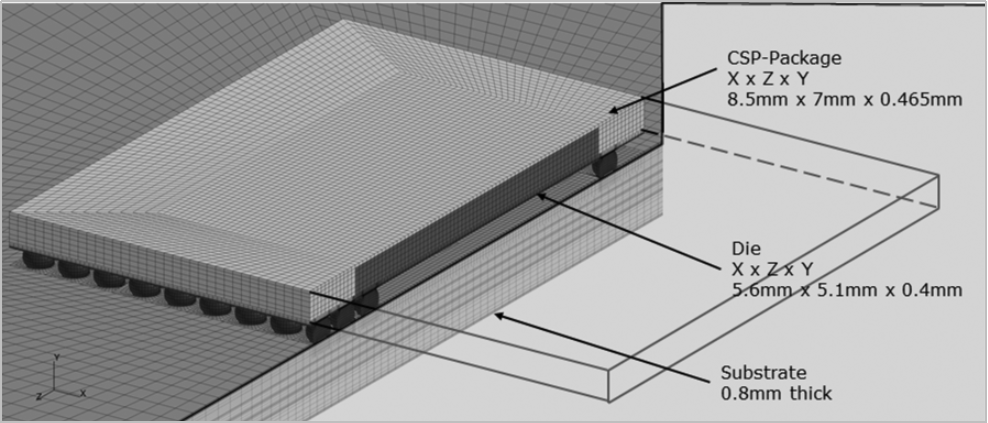
图3.单对称无底部填充参考模拟模型
论文链接:
https://doi.org/10.1115/1.4056445
2
电介质材料
1、Nature:用于高温电容储能的梯形共聚物
为了应用于高温电容储能,聚合物介电材料需要同时具有低导电性和高导热性。如何使材料同时具有这些看似矛盾的性能十分具有挑战性。
最近,上海交通大学等机构的研究人员报道了一种在高电场和高温下,电导率比现有聚合物低一个数量级以上的梯蕃(ladderphane)共聚物。因其较低的电导率,该ladderphane共聚物在200℃下充放电效率为90%的放电能量密度为5.34 J cm−3,,超过了现有的介电聚合物和复合材料。通过π–π堆叠相互作用,ladderphane共聚物自组装成高度有序阵列,从而产生1.96 ± 0.06 W m−1 K−1的本征贯穿平面热导率。共聚物膜的高导热性实现有效的焦耳热耗散,因此在高温和高电场下具有优异的循环稳定性。该研究展现了ladderphane共聚物在极端条件下的高能量密度聚合物电容器中的应用前景,为未来高温储能介质材料的发展提供了参考。该工作以“Ladderphane copolymers for high-temperature capacitive energy storage”发表于Nature上。
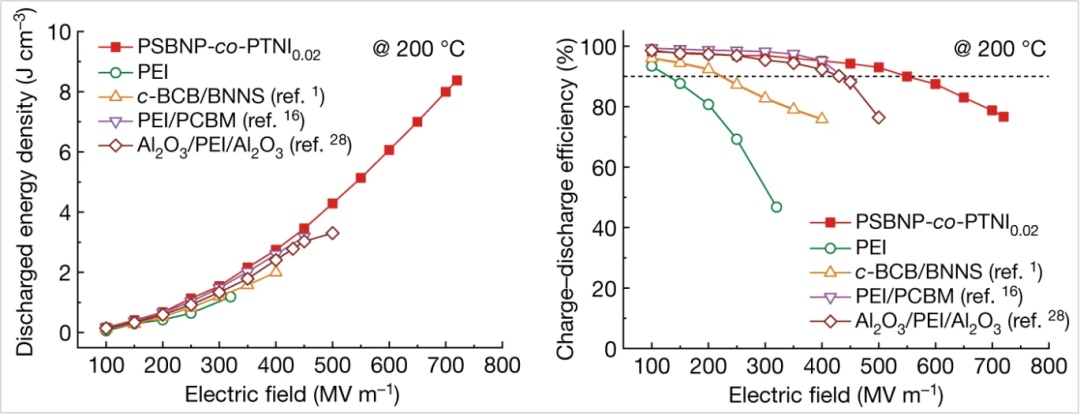
图4. ladderphane共聚物(PSBNP-co-PTNI0.02)以及其他聚合物和复合薄膜的放电能量密度和充放电效率对比图
论文链接:
https://doi.org/10.1038/s41586-022-05671-4
3
热管理材料
1、Small:通过双hBN包封的超高界面热传导实现2D电子器件的有效热管理
散热问题一直是限制高性能电子器件发展的主要因素,在超薄层、异质结构和界面组成的新型纳米电子器件中尤为突出,因为这些器件需要高效的热传导性能。
最近,凯斯西储大学等机构的研究人员报道了一种拥有超高界面热导率的结构,即单层过渡金属二硫化物MX2(MoS2、WSe2、WS2)夹在两个六方氮化硼(hBN)层之间组成的包封范德华(vdW)异质结构。通过在不同激光功率和温度下,对悬浮和衬底支撑的hBN/MX2/hBN异质结构进行拉曼光谱测量,校准了垂直堆叠中的面外界面热导率。测得MX2和hBN之间的界面热导率为74 ± 25 MW m-2K-1,比非包封结构中MX2的界面热导率高出十倍以上。此外,分子动力学(MD)计算验证并解释了实验结果,表明hBN层的完全包封是高界面热导率的原因,超高界面热导率归因于两种晶体二维材料之间的双重传热路径和清洁、紧密的vdW界面。该研究揭示了hBN/MX2/hBN结构中的新热传输机制,并为构建具有高效热管理的新型hBN包封纳米电子器件提供了新的思路。该文章以“Ultra-High Interfacial Thermal Conductance via Double hBN Encapsulation for Efficient Thermal Management of 2D Electronics”发表在Small上。

图5.hBN包封结构和其他器件结构示意图及界面热导率比较
论文链接:
https://doi.org/10.1002/smll.202205726
4
电磁屏蔽材料
1、Adv. Mater.:在聚酰亚胺复合薄膜上可控分布Ti3C2Tx空心微球以实现优异电磁屏蔽性能
聚合物基柔性多功能电磁干扰(EMI)屏蔽复合薄膜在5G通信技术、可穿戴电子设备和人工智能领域有重要应用。
近日,西北工业大学等机构的研究人员基于多孔/多层结构设计,以聚酰亚胺(PI)为基体,以聚甲基丙烯酸甲酯(PMMA)微球为模板,通过牺牲模板法成功制备出Ti3C2Tx空心微球孔径和分布可控的柔性(Fe3O4/PI)-Ti3C2Tx-(Fe3O4/PI)复合薄膜。由于多孔/多层结构,当Ti3C2Tx空心微球的孔径为10 μm,PMMA/Ti3C2Tx的质量比为2:1时,复合薄膜具有最优异的EMI屏蔽性能,EMI屏蔽效能(EMI SE)可达85dB。并通过有限元模拟进一步验证了该复合薄膜在电磁波屏蔽方面具有出色的效能。此外,该复合薄膜还具有良好的导热性(导热系数为3.49 W m-1K-1)和机械性能(拉伸强度为65.3 MPa)。这种柔性复合膜具有优异的电磁屏蔽性能、导热性能和机械性能,在大功率、便携式和可穿戴柔性电子设备的电磁干扰防护方面显示出巨大的应用潜力。该文章以“Controlled Distributed Ti3C2Tx Hollow Microspheres on Thermally Conductive Polyimide Composite Films for Excellent Electromagnetic Interference Shielding”发表于Adv. Mater.上。
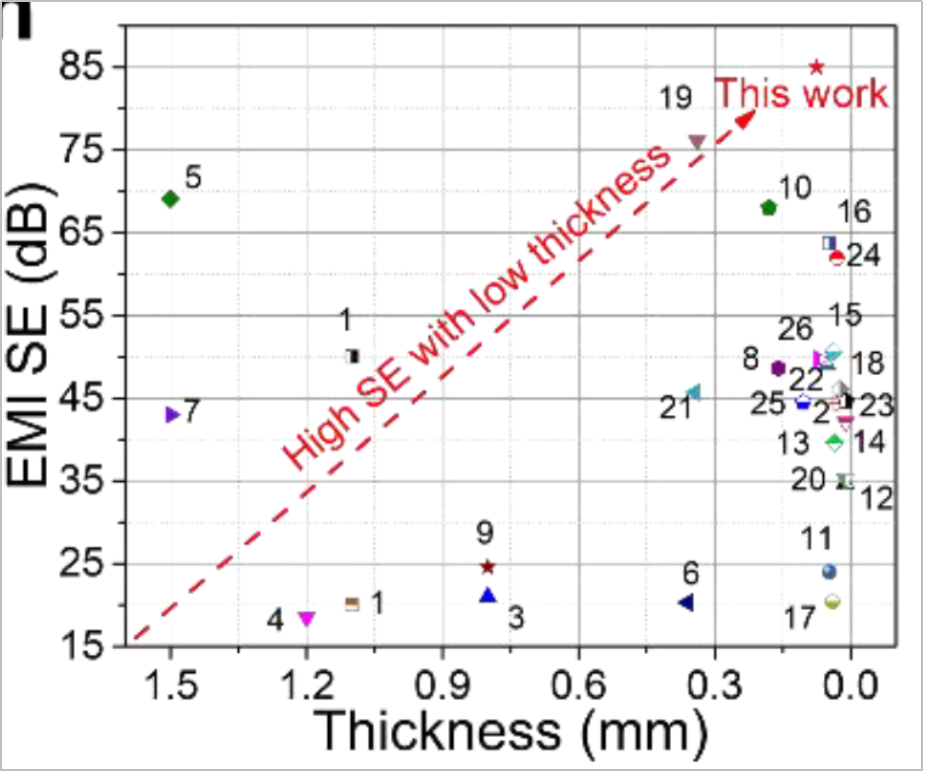
图6. (Fe3O4/PI)-Ti3C2Tx-(Fe3O4/PI)复合薄膜及其他材料的EMISE与厚度的关系
论文链接:
https://doi.org/10.1002/adma.202211642
5
热电材料
1、Adv. Funct. Mater.:通过外延应变的合理控制使Mg3Sb2薄膜的价带收敛从而提高热电性能
应变工程被证明可以有效地调节材料的性能,例如热电、铁电和光伏性能。外延应变作为应变工程的直接途径,经常被提出可用于合理控制热电材料的电子结构和性能,但缺乏相关实验验证。
近日,武汉理工大学等机构的研究人员证实了通过可调谐的大外延应变,以及衬底的选择,可实现Mg3Sb2外延膜的价带收敛。Mg3Sb2薄膜中高达8%的大外延应变是应变工程中最重要的结果之一。角分辨光电子能谱测量和理论计算揭示了外延应变在调控Mg3Sb2的晶场分裂和能带结构中的关键作用。通过平面压缩应变适当调控晶场效应,在应变Mg3Sb2膜中清楚地发现了价带收敛。因此,通过应变工程使Mg3Sb2膜的热电功率因数达到了0.94 mW m−1 K−2,远远超过松弛应变的Mg3Sb2。这项工作为有效控制Mg3Sb2和其他热电薄膜的外延应变和能带会聚提供了参考。该项研究以“Rational Manipulation of Epitaxial Strains Enabled Valence Band Convergence and High Thermoelectric Performances inMg3Sb2 Films”发表于Adv. Funct. Mater.上。
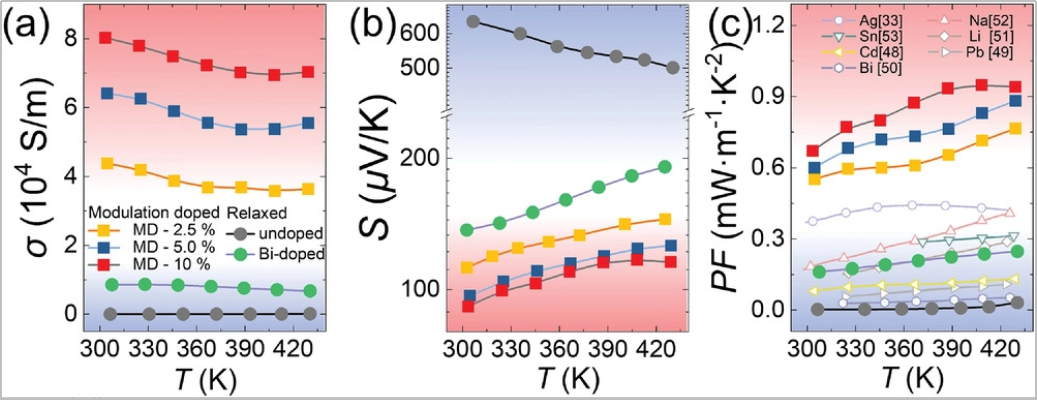
图7. 松弛应变和平面压缩应变Mg3Sb2薄膜热电性能(电导率σ、塞贝克系数S、功率因数PF)与温度的关系
论文链接:
https://doi.org/10.1002/adfm.202300154




