1科研动态
1、IEEE T. Comp. Pack. Man.:具有Cu柱的高集成度面板级扇出型封装的翘曲预估和演示
扇出面板级封装(FO-PLP)已成为一项关键的前瞻性技术,因为它可以满足小尺寸、高输入/输出引脚数和多芯片功能的需求。此外,使用Cu柱的互连可以实现称为packaging-on-packaging的三维堆叠结构。然而,FO-PLP在制造过程中严重的翘曲问题导致了许多问题,如组装困难、器件可靠性低和产品良率低等。
近日,中国台湾国立清华大学等机构的研究人员提出了一种面向过程的有限元分析方法,以估算在制造过程中由于不同材料的热膨胀系数之间的不匹配而导致的整个翘曲的变化。值得注意的是,在进行模拟估计时,关于FO-PLP中复杂再布线层(RDL)的模型构建遇到了严重的挑战,因此采用模拟提取的等效力学特性分别重新定义了RDL和Cu柱的材料特性。此外,将改进的Timoshenko双层理论与FO-PLP的面向过程的有限元分析相结合,以阐明RDL的无应力等效温度。研究人员制造了一个带有Cu柱的真实FO-PLP器件进行测量,以证明所提出的模拟方法的可靠性。实验结果发现,模拟预测和实验之间的平均偏差小于10%。析因设计的结果表明,电介质和RDL的力学性能是主要影响因素,并对FO-PLP的翘曲程度产生交互影响。这项工作的结果可以作为FO-PLP翘曲评估的指南。该文章以“Warpage Estimation and Demonstration of Panel-level Fan-out Packaging with Cu Pillars Applied on a Highly Integrated Architecture”发表于IEEE T. Comp. Pack. Man.上。
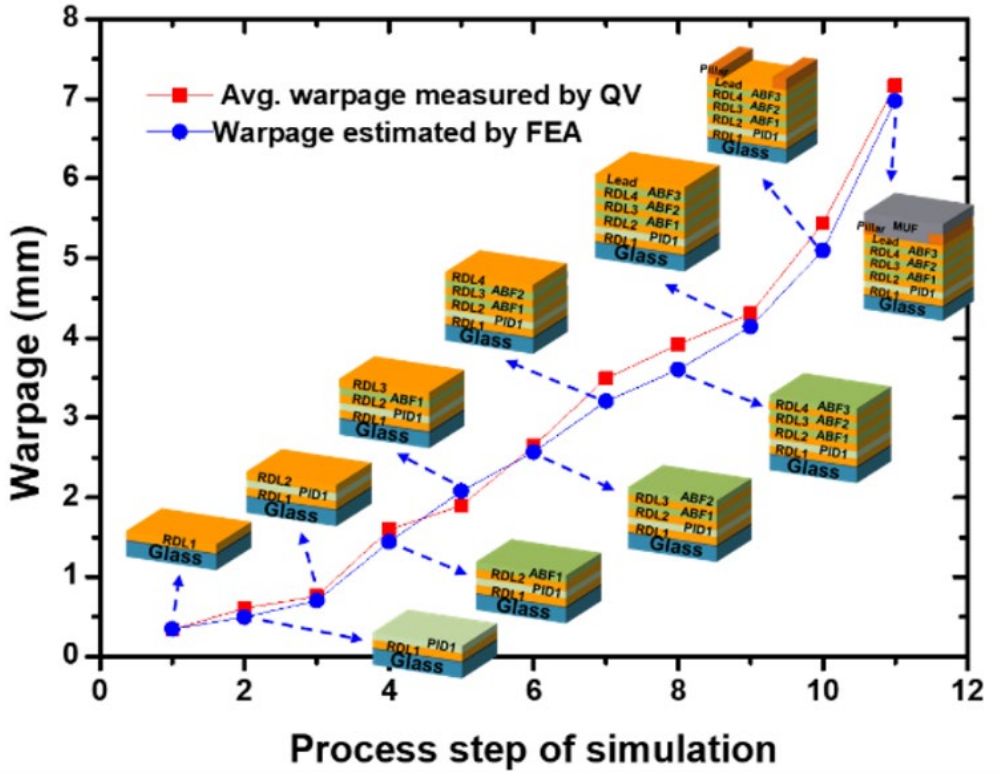
图1. 实验测量的翘曲和在室温下通过面向制造工艺的模拟获得的翘曲的逐步比较
论文链接:DOI 10.1109/TCPMT.2023.3269424
2、 IEEE T. Comp. Pack. Man.:微电子封装低温焊料综述
由于焊料向无铅方向的转变,导致Sn-Ag-Cu(SAC)合金因其优异的机械性能和可靠性而成为最常用的焊料。然而,该类合金的熔化温度范围(217-222℃)远高于Pb基焊料的熔化温度范围。随着微电子封装在先进制程和复杂异质结构上的进步,SAC基焊料较高的熔化温度显著影响封装应力,导致接头质量差和早期层间电介质(inter-layer dielectric,ILD)分层失效。因此,无铅低温焊料(low temperature solders,LTS)已经将发展重点放到了新型合金成分上。Sn-Bi和In基焊料已成为低温焊料的主要候选材料。
近日,佐治亚理工学院等机构的研究人员详细介绍了低温焊料的关键性能要求,并评估了合金改性对Sn-Bi和In基焊料体系的微观结构、热/机械性能、润湿性和可靠性的影响。文章还讨论了潜在的需关注的领域,特别是介于SAC基与全低温焊料之间的混合低温焊料。为低温焊料的研发工作提供了参考。该文章以“A Review of Low Temperature Solders in Microelectronics Packaging”发表于IEEE T. Comp. Pack. Man.上。
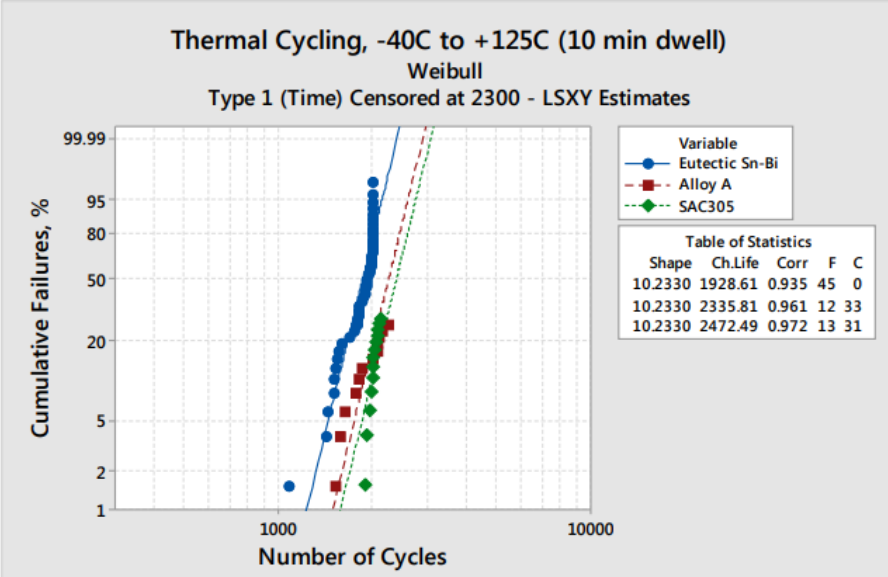
图2. SAC和Sn-Bi共晶合金的热循环表现
论文链接:DOI 10.1109/TCPMT.2023.3271269
3、J. Electron. Packaging:加热功率对扇出封装的球栅阵列热冲击可靠性的影响
功率器件的自热效应和芯片散热会使器件内部产生较大热应力而引起变形,从而导致元器件性能恶化甚至失效。因此,电子封装的可靠性研究尤为重要。
近日,西南电子设备研究所等机构的研究人员开展了具有球栅阵列(BGA)的Fan-out微系统封装在热冲击下的可靠性研究。研究人员对硅衬底施加不同功率的热源,模拟功率器件的功耗诱导热,并采用Anand本构模型和Darveaux寿命模型对封装结构的热疲劳寿命进行了研究。有限元模拟结果表明,热疲劳寿命与热源功率不呈正相关,在一定的功率范围内,热疲劳寿命先增加后减少。为了解释这种异常现象,研究人员对不同加热功率(10–55 W)的焊球进行了疲劳分析。结果表明,在低温阶段,随着热源功率的增加,热源在一定程度上抵消了低温效应,焊球的应力值降低;在高温阶段,球的应力几乎不受影响,然而,随着热源功率的进一步增加,结构的热变形逐渐严重,抵消低温效应的效果降低,热疲劳寿命随着热源功率增加而降低。该研究成果为微系统封装设计提供了参考。该文章以“Effect of Heating Power on Ball Grid Array Thermal Shock Reliability for a Fanout Package”发表于J. Electron. Packaging上。

图3. 不同功率热源下的BGA底部单元应变能密度增量及热疲劳寿命
论文链接:https://doi.org/10.1115/1.4062344
4、Small:用于电磁波吸收、热管理和阻燃的新型环氧基封装材料
下一代集成电路的尺寸急剧减小和功率密度增加导致电磁干扰和热失效,这也成为聚合物基电子封装材料广泛应用的关键障碍。
近日,华中科技大学的研究人员展示了一种具有高电磁波吸收率、高导热性和良好阻燃性能的多功能环氧基复合材料——三聚氰胺衍生碳泡沫@层状双氢氧化物/环氧树脂(MDCF@LDH/EP)。其多孔结构和异质界面的协同作用促进了电磁波的多重反射和吸收以及介电损耗。在仅填充10 wt%的情况下,可实现−57.77 dB的低反射损耗和7.20 GHz的有效吸收带宽。同时,由于高度连续的3D三聚氰胺衍生碳泡沫(MDCF)为声子的传输提供了一条广阔的路径,促使环氧树脂基体的热导率提高了241.4%。此外,该复合材料还表现出很高的热稳定性和阻燃性,与纯环氧树脂相比,峰值放热率和总放热率分别降低了19.4%和30.7%。如此出色的综合性能使其成为一种很有前景的电子封装材料。该文章以“Multifunctional Epoxy-Based Electronic Packaging Material MDCF@LDH/EP for Electromagnetic Wave Absorption, Thermal Management, and Flame Retardancy”发表在Small上。
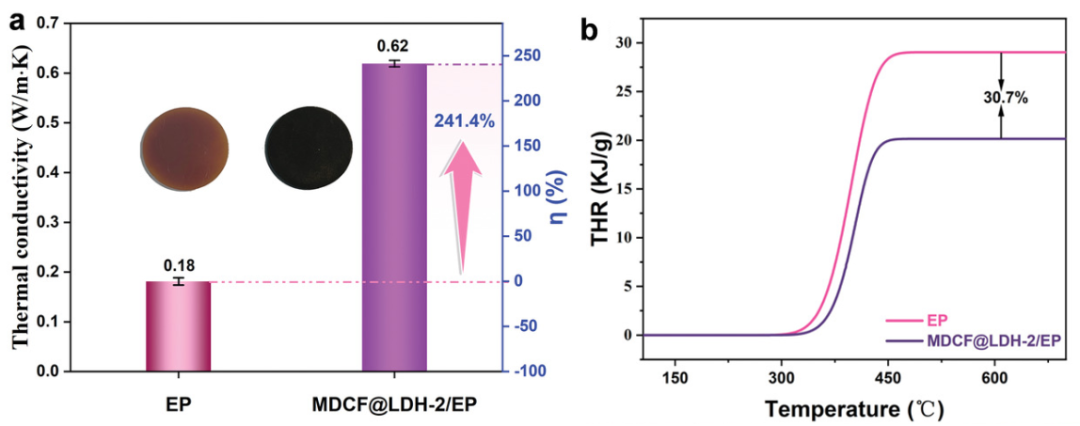
图4. MDCF@LDH/EP的(a)导热性能和(b)阻燃性能
论文链接:https://doi.org/10.1002/smll.202204303
2技术动态
1、DARPA:DARPA颁布Minitherms3D热管理系统开发资助计划
2023年1月23日,美国国防高级研究计划局(DARPA)微系统技术办公室(MTO)发布Minitherms3D计划的公告,该计划旨在促进3D异构集成(3DHI)中热管理系统的开发。并预计于2023年10月份正式启动对中标的各提案的补助,拨款总额为6900万美元。
目前集成电路往小型化和高功率的方向不断发展,越来越紧凑的微系统中热管理不足的问题急需得到解决。多层高功率逻辑或其他功能块(包括射频设备)的3D堆叠被认为能进一步显著提高微系统的功能,但是3D堆叠中每层结构在面内和面外热量传导能力的不足、不同功能块之间热隔离较差,限制了微系统能力的提高,特别是在射频系统、图像分析和高性能计算方面(包括人工智能和机器学习等应用领域)。
DARPA正寻求研究和开发紧凑型热管理创新技术,并应用到3D异构集成芯片中的高功率层。具体目标包括:5层3D堆叠;总散热>6.8 kW(目前单层最先进的逻辑芯片(SOTA)为1kW);散热系统体积限制在0.006 m3(比SOTA小2倍)以内。并且要求提出的热管理方法必须与给定应用的电气设备和互连性能目标兼容。
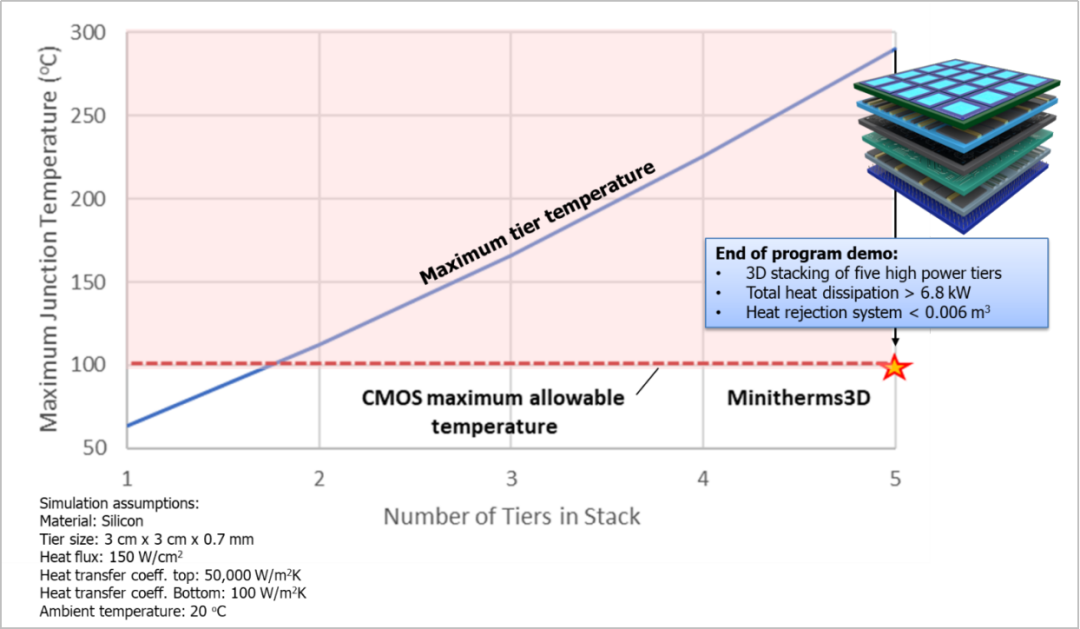
图5. 顶底部散热的硅基3D堆叠结构的每层最高温度
同时,DARPA指出,为实现Minitherms3D的目标,需要克服以下技术挑战(TC):降低内部和外部热阻。
TC1a.在不增加层厚度的情况下增加层内热传导。3DHI层中平均热通量> 150 W/cm2的区域和局部> 1 kW/cm2热点区域必须同时进行热管理,以保持芯片温度在合适范围内;
TC1b.增加相邻功能块之间面内和面外的热隔离。热隔离指隔离区和半导体主体的热导率之比,必须小于0.0002以降低存储器的刷新频率,而由于金属互连和封装材料的热传递,目前的堆叠方法的比率为0.01。
TC1c.保持低热阻的同时增加每层的散热量。为了实现5层堆叠结构(30 mm x 30 mm x 700 µm和50µm互连层),在150 W/cm2的热通量下,热阻需要小于0.09 cm2℃/ W ,以将层最高温度控制在 100 ℃ 以下。
TC2a.降低连接热阻。从堆叠系统到环境的总热阻=内部电阻(TC1)+连接热阻(TC2a)+散热部件的热阻(TC2b),由于空气侧相对较低的热导率,导致第三部分的热阻占总热阻的70%,因此前两种热阻必须低于10-15%。
TC2b.增加体积散热能力,同时减少对空气的热阻。对给定的对流条件和环境温度,散热器的体积往往随散热要求线性增加,因此高功率意味着更大尺寸和重量,进而使应用受到限制。
DARPA还强调,Minitherms3D方案必须关注多功能的协同设计,并确定最佳设计选择,以满足所选择的预期应用的性能和可能性。

图6. 3DHI堆叠结构所面临的内外部热管理挑战
(Source:DARPA)




