跟小编一起来看看近期国内外电子材料领域都有哪些最新研究进展吧~
01 科研动态
1、Nature:用于高温电容储能的梯形共聚物
用于高温下的电容式储能,介电聚合物需要同时具有低电导率与高导热性。这些性质看起来是无法同时实现的,也是现有聚合物基材料面临的一个持续挑战。
近日,上海交通大学等机构的研究人员制备得到了一种梯形共聚物,在高电场和高温下表现出比现有聚合物低一个数量级以上的电导率。梯形共聚物具有5.34 J cm−3的放电能量密度,在200°C时充放电效率为90%,优于现有的介电聚合物和复合材料。梯形共聚物通过π-π堆叠相互作用自组装成高度有序的阵列,从而产生 1.96 ± 0.06 W m−1K−1 的固有平面导热系数。共聚物薄膜的高导热性允许高效的焦耳散热,因此在高温和高电场下具有出色的循环稳定性。共聚物还被证明具有击穿自愈能力,进一步表明了梯形结构在极端工作条件的高能量密度聚合物电容器的应用前景。该文章以“Ladderphane copolymers for high-temperature capacitive energy storage”发表于Nature上。
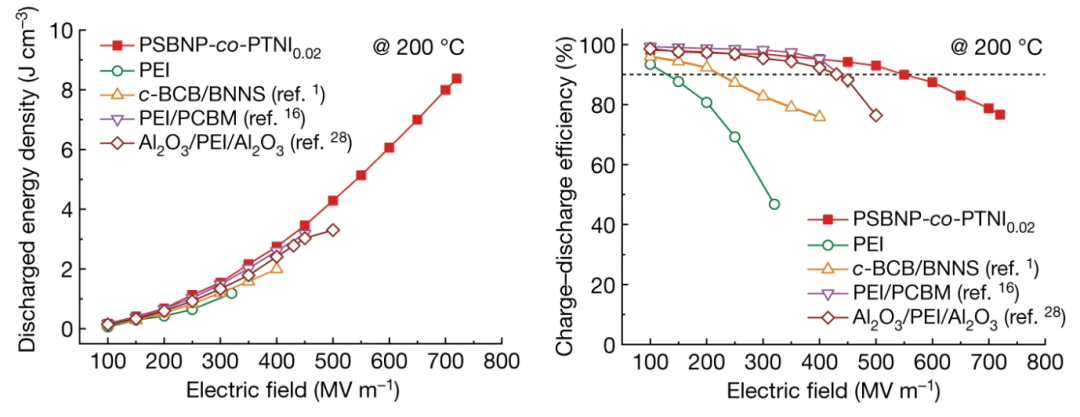
图1. 不同材料放电能量密度与充放电效率比较
论文链接:https://doi.org/10.1038/s41586-022-05671-4
2、Adv. Mater.:超强高韧性热固性环氧树脂超支化拓扑结构和亚纳尺度自由体积
热固性环氧树脂的强度和韧性通常是相互排斥的,高性能和快速可回收性也是如此。实验测定的机械强度值通常远低于其理论值。制备具有高模量、高韧性、超强强度和高效可回收性的热固性环氧树脂仍然是一个巨大的挑战。
近日,中南民族大学等机构的研究人员首次利用点击化学技术将酰亚胺结构引入环氧树脂中,制备了一系列拓扑结构可控的超支化聚酰亚胺环氧树脂(Bn),进一步将其引入复合商业化通用环氧树脂(DGEBA)中。结果发现,Bn在同时DGEBA的强度、模量、韧性、耐低温性和降解性方面表现出优异的综合功能,随着自由体积分数、自由体积孔尺寸和孔平均尺寸分布的降低,共聚物的强度和韧性呈现出了先增加后降低的变化趋势。这种提升归因于线性和超支化拓扑结构的分子混合物的均匀分子空穴或自由体积。另外,首次提出了环氧树脂分子自由体积的精确测量和控制。该项研究成功解决了强度和韧性之间以及使用时的高性能和降解时的高效率之间的两个冲突。这些发现为设计超强、高韧和可回收的热固性环氧树脂提供了一条有效途径。该文章以“Ultra-Strong and High-Tough Thermoset Epoxy Resins from Hyperbranched Topological Structure and Subnanoscaled Free Volume”发表于Adv. Mater.上。
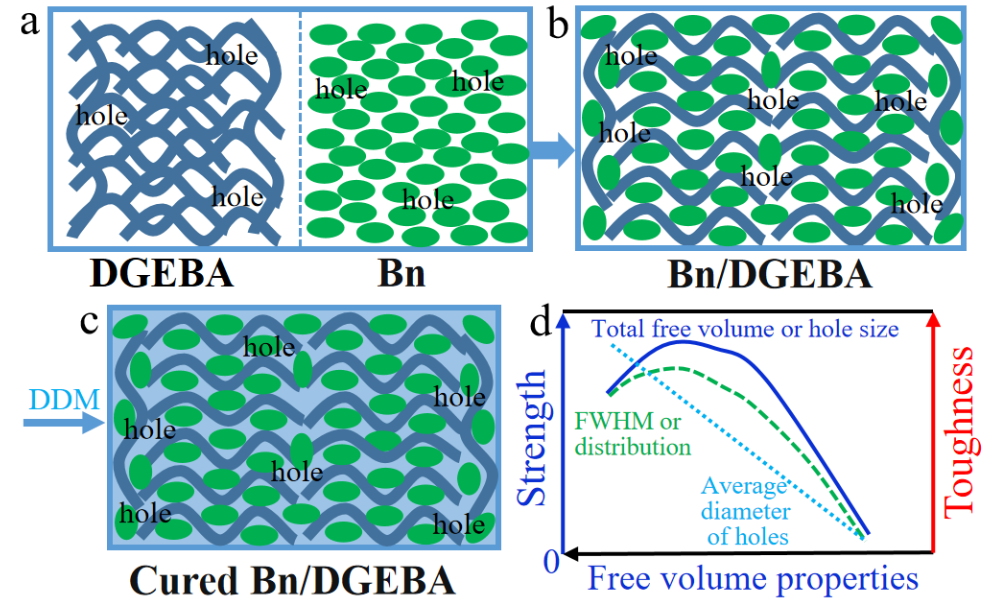
图2. Bn/DGEBA共聚物的增强增韧机制
论文链接:https://doi.org/10.1002/adma.202308434
3、J. Electron. Packaging:持续高温作业下底部填充胶粘弹性的微观结构演化
汽车发动机罩下电子设备的工作温度高达150–200 °C,使用时长接近10 年。消费电子产品一般在55–85℃的温度下运行,使用寿命为3-5年。底部填充材料用于为细间距阵列焊点提供保护,并满足可靠性要求。
近日,美国奥本大学的研究人员将多种不同的底部填充材料置于汽车发动机罩温度下,研究长时间等温暴露对底部填充胶微观结构和动态力学性能的影响。将两种不同的底部填充材料进行三种不同的等温暴露(低于、接近和高于玻璃化转变温度),研究了储能模量、损耗模量、tanδ等动态力学粘弹性及其各自的玻璃化转变温度。研究人员采用偏光显微镜测量氧化层厚度,对底部填充胶的氧化行为进行了实验研究,并利用动态力学分析仪(DMA)研究了底部填充胶的动态力学性能对其力学性能的影响。结果表明,等温老化会使底部填充物氧化,从而显著改变材料的力学性能。该研究为底部填充胶材料老化失效行为提供了参考。该文章以“Microstructural Evolution of Viscoelastic Properties of Underfills Under Sustained High Temperature Operation”发表于J. Electron. Packaging上。

图3. 150℃老化下不同时间底部填充胶的氧化层
论文链接:https://doi.org/10.1115/1.4052715
4、J. Electron. Packaging:氮化硼/环氧树脂复合材料对倒装芯片可靠性的影响
在电-热-机械耦合的作用下,容易发生电子器件的故障和性能下降,已成为微电子封装中一个重大的可靠性问题。
近日,中南大学等机构的研究人员研究了利用热界面材料(TIM)提高倒装芯片可靠性的方法。首先,建立了倒装芯片封装系统的三维有限元模型,并对电-热力多场耦合进行了有限元模拟。然后,分析了高电流密度下倒装芯片的焦耳热、温度分布、热应力和变形。同时,研究了TIM的导热系数和工作电流对倒装芯片可靠性的影响。结果表明,当TIM的热导率从0.2 W/m·K增加至6 W/m·K时,倒装芯片的最高温度和最大等效应力分别降低了6.35 °C和14.6 MPa。最后,通过实验与仿真相结合的方法,分析了热界面材料对倒装芯片可靠性的影响。进一步证实了制备的高导热氮化硼纳米片/环氧树脂复合材料有效地提高了电子器件的可靠性和使用寿命。该文章以“Effect of Hexagonal-Boron Nitride/Epoxy and BNNS/Epoxy Composite Materials on the Reliability of Flip Chip”发表于J. Electron. Packaging上。
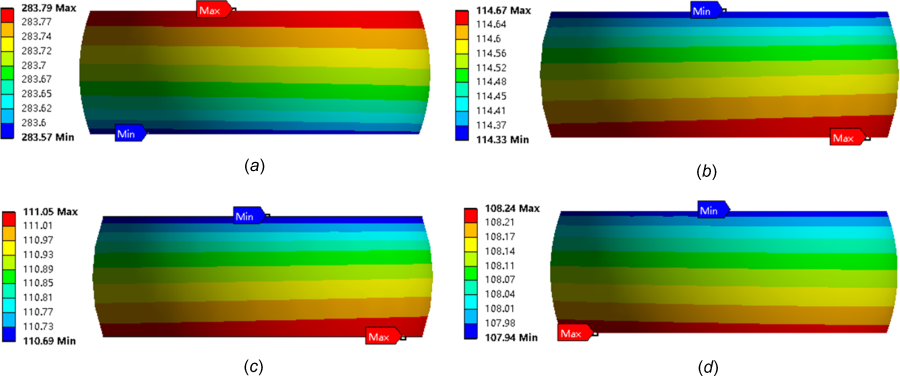
图4. 倒装芯片焊点的温度分布:
(a)无TIM(b)、(c)、(d)TIM 热导率分别为0.2、0.5 、6 W/m·K
论文链接:https://doi.org/10.1115/1.4051468
02 技术动态
1、关于Intel玻璃基板的简要介绍
此前,英特尔(Intel)在其年度发布会上宣布,到2030年,将实现在一块封装芯片中集成1万亿个晶体管,同时会上还展示了有关玻璃基板的更多细节。另外,在加利福尼亚州圣何塞举行的“英特尔创新”活动上,Intel宣布玻璃基板将在这个十年的后半程实现商业首发。本文将简单介绍什么是玻璃基板以及它与传统有机基板的不同之处。
(1)玻璃基板是一项全新的技术
图5为Intel展示的一颗功能齐全的测试芯片,该芯片使用75 μm的玻璃通孔(TGV),横纵比为20:1,核心厚度为1 mm。大概十年前,Intel这家半导体巨头公司就开始进行玻璃基板方面的研发工作,至今投入已经超10亿美元,研发团队约600人规模,同时还建立了一条全新的生产线。

图5. Intel展示的使用玻璃基板的测试芯片
玻璃基板可以实现比传统有机基板更紧密的信号间距,对于服务器或数据中心使用的高功耗大芯片来说,使用玻璃基板在速率和功耗方面都具有一定优势。同时,随Chiplet概念的发展,玻璃基板也有助于将更多芯粒封装到一个系统中。
(2)技术优点
玻璃的成分主要是二氧化硅,在高温下性质更加稳定。由于高性能芯片往往散热量巨大,玻璃基板在高温下的热稳定性和机械稳定性将使芯片的热管理变得更加高效。其次,为避免封装在生产过程中弯曲,小芯片之间必须要有非常高密度的互联,而玻璃基板可满足更高的互联密度需求。另外,玻璃具有更高的平坦度,这也将使得光刻和封装变得更加容易。Intel内部消息称使用玻璃基板可以使图案的失真降低50%,以提高光刻的聚焦深度,从而使半导体制造更加精确。
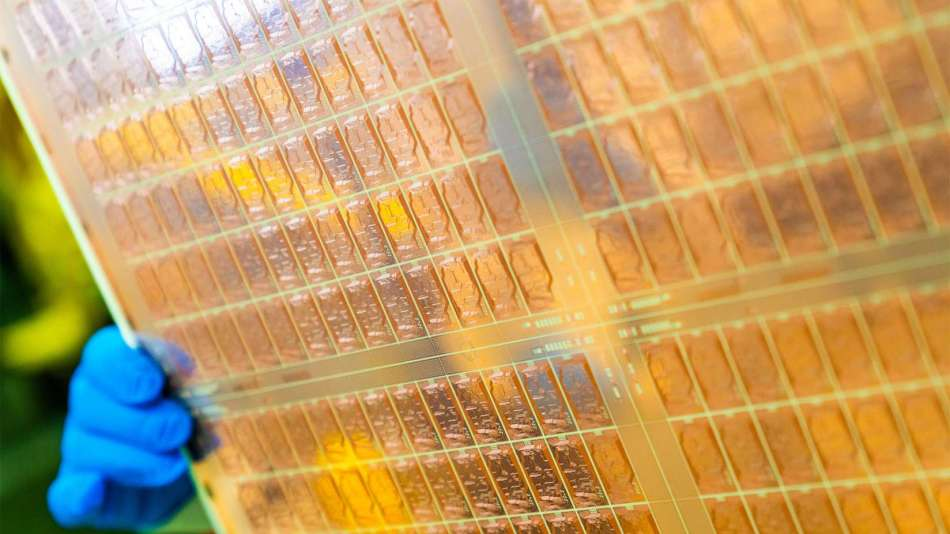
图6. Intel玻璃基板
(3)与封装和Chiplet的联系
玻璃基板的提出与先进封装和Chiplet概念密不可分。基板是用来承载芯片的介质,是芯片封装的重要部分,基板除了可以确保芯片的结构稳定性,还扮演将信号从芯片内部传输到封装结构的角色。因此玻璃基板的优越机械性能和高互联密度将助力产生更高性能的芯片封装。
玻璃基板尤其适用于Chiplet概念,可以将更多的晶体管容纳到一个封装结构中。得益于玻璃基板的更高互联密度,同样大小的基板可容纳更多芯粒之间的连接。换句话说,可以在同样的封装中集成更多的芯粒。
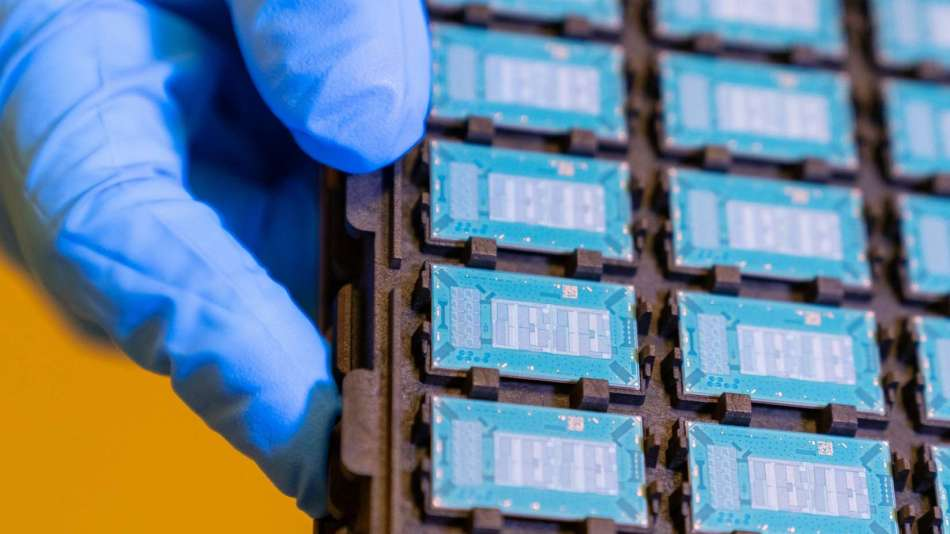
图7. 玻璃基板是对先进封装技术的补充
(4)应用时机
玻璃基板除了能克服诸如互联密度和耐高温等方面的挑战之外,在制造用于数据人工智能(AI)和高性能计算(HPC)的大芯片时,机械和电气性能方面也比有机基板优越,可以承载的功率和数据互联是有机基板的10倍。Intel认为,在未来几年内,使用有机材料在硅封装上扩增晶体管将达到极限,玻璃基板将是半导体行业下一步重要发展方向。
(5)需要考虑的问题
Intel的技术开发执行副总裁Ann Kelleher认为玻璃基板的技术创新已经完成,接下来需要考虑生产成本问题。不像有机基板经过大量的测试和长期的应用,玻璃基板的生产和应用将更加昂贵,将在初期面临收益率问题。更为重要的是,玻璃基板需要建立一套商业生产生态系统,包括必要的生产工具和供应能力。这也是Intel与玻璃处理设备与材料供应商之间密切合作的原因。另外Intel还需要为这种新型基板的封装测试寻找外包商。
一家总部位于加州的芯片制造商计划适时向Intel晶圆代工厂提供玻璃基板,并有信心将成本降至与现有有机基板同等水平。同时Intel认为玻璃基板和有机基板在未来几年将共存一段时间。
总的来说,玻璃基板将是一次重大的技术转型,将为Intel的技术竞争力带来飞跃,尤其是在为人工智能和数据中心服务的高端芯片方面。
(source: five facts you need to grasp to understand Intel’s glass substrate, EDN)




